еә”еҜ№зі»з»ҹзә§е°ҒиЈ…SiPй«ҳйҖҹеҸ‘еұ•жңҹпјҢзҺҜж—ӯз”өеӯҗе…ҲиҝӣеҲ¶зЁӢз ”еҸ‘дёӯеҝғжҡЁеҫ®е°ҸеҢ–жЁЎеқ—дәӢдёҡеӨ„еүҜжҖ»з»ҸзҗҶиөөеҒҘе…Ҳз”ҹеңЁзі»з»ҹзә§е°ҒиЈ…еӨ§дјҡSiP Conference 2021дёҠжө·з«ҷдёҠпјҢеҲҶдә«зі»з»ҹзә§е°ҒиЈ…SiPжҠҖжңҜдјҳеҠҝгҖҒж ёеҝғз«һдәүеҠӣеҸҠж•ҙеҗҲи®ҫи®ЎдёҺеҲ¶зЁӢдёҠзҡ„жҢ‘жҲҳпјҢиҺ·еҫ—зғӯеҲ—еӣһе“ҚгҖӮ 

зі»з»ҹзә§е°ҒиЈ…SiPзҡ„еҫ®е°ҸеҢ–дјҳеҠҝжҳҫиҖҢжҳ“и§ҒпјҢйҖҡиҝҮж”№еҸҳжЁЎз»„еҸҠXYZе°әеҜёзј©е°ҸжҸҗдҫӣз»Ҳз«Ҝдә§е“ҒжӣҙеӨ§зҡ„з”өжұ з©әй—ҙпјҢйӣҶжҲҗжӣҙеӨҡзҡ„еҠҹиғҪпјӣйҖҡиҝҮејӮиҙЁж•ҙеҗҲеҮҸе°‘з»„иЈ…еҺӮзҡ„е·ҘеәҸпјҢеҠ дёҠжӣҙй«ҳеәҰиҮӘеҠЁеҢ–зҡ„е·ҘиүәеңЁеүҚз«ҜйӣҶжҲҗпјҢйҷҚдҪҺдә§дёҡй“ҫеӨҚжқӮеәҰпјӣжӯӨеӨ–пјҢзі»з»ҹзә§е°ҒиЈ…SiPе®һзҺ°жӣҙеҘҪзҡ„з”өзЈҒеұҸи”ҪеҠҹиғҪпјҢиҝҗз”ЁжЁЎеЎ‘(Molding Compound)еҠ дёҠжә…й•Җ(Sputter)жҲ–е–·ж¶Ӯ(Spray Coating)жҠҖжңҜпјҢе®һзҺ°еҜ№еӨ–з•Ңз”өзЈҒиҫҗе°„зҡ„еұҸи”ҪдёҺжЁЎеқ—еҶ…йғЁдёҚеҗҢеҠҹиғҪд№Ӣй—ҙзҡ„еұҸи”ҪпјҢзү№еҲ«йҖӮз”ЁдәҺйў‘ж®өи¶ҠжқҘи¶ҠеӨҡзҡ„5G mmWaveжЁЎеқ—дёҺTWSзңҹж— зәҝи“қзүҷиҖіжңәзӯүгҖӮ
еҸҰдёҖж–№йқўпјҢеҖҹз”ұж—ҘжңҲе…үе’Ңе®ўжҲ·е…ұеҗҢи®ҫи®Ўзҡ„дјҳеҠҝдёҺжүҺе®һзҡ„е°ҒжөӢжҠҖжңҜеҲ°зі»з»ҹз»„иЈ…зҡ„з»јеҗҲиғҪеҠӣпјҢеӣ еә”дә§е“ҒдёҠз”өжәҗз®ЎзҗҶжЁЎеқ—гҖҒе…үеӯҰгҖҒдј ж„ҹеҷЁжЁЎеқ—гҖҒе°„йў‘гҖҒеҸҜзј–зЁӢеәҸеӯҳеӮЁеҷЁ(AP Memory)зӯүзӯүеҠҹиғҪеӨҡж ·еҢ–йңҖжұӮпјҢжЁЎз»„еҢ–и®ҫи®Ўзҡ„дҫҝеҲ©жҖ§пјҢжӣҙеҲӣж–°и®ҫи®Ўеә”з”ЁпјҢеҲ©з”Ёж ёеҝғз«һдәүеҠӣзҡ„дё»жқҝзә§з»„иЈ…(Board Level)иғҪеҠӣпјҢдёәз»Ҳз«Ҝдә§е“Ғи®ҫи®ЎжҸҗдҫӣжӣҙеӨ§зҡ„зҒөжҙ»жҖ§гҖӮ
зі»з»ҹзә§е°ҒиЈ…зҡ„дјҳеҠҝ

е…Ҳиҝӣзҡ„е·ҘиүәгҖҒжөӢиҜ•еҸҠEE/RF硬件и®ҫи®ЎиғҪеҠӣзӯүе°ҶжҺЁеҠЁзі»з»ҹзә§е°ҒиЈ…SiPжҠҖжңҜдёҚж–ӯеҲӣж–°пјҢж•ҙдҪ“е·ҘиүәжҲҗжң¬е°Ҷдјҡи¶ҠжқҘи¶ҠжңүдјҳеҠҝпјҢе…¶дјҳи¶Ҡзҡ„жҖ§иғҪе°Ҷи¶ҠжқҘи¶ҠеӨҡең°еә”з”ЁеңЁжӣҙеӨҡз©ҝжҲҙдә§е“ҒпјҢеҰӮжҷәиғҪзңјй•ңгҖҒж”ҜжҢҒ5Gе’ҢAIзҡ„зү©иҒ”зҪ‘гҖҒжҷәиғҪжұҪиҪҰеҸҠз”ҹзү©еҢ»еӯҰзӯүеҜ№е°әеҜёжңүзү№еҲ«иҰҒжұӮзҡ„еә”з”ЁйўҶеҹҹпјҢжҸҗдҫӣе®ўеҲ¶еҢ–и®ҫи®ЎдёҺи§ЈеҶіж–№жЎҲгҖӮ
еҚ•йқўеЎ‘е°Ғ
Single Side Molding, SSM
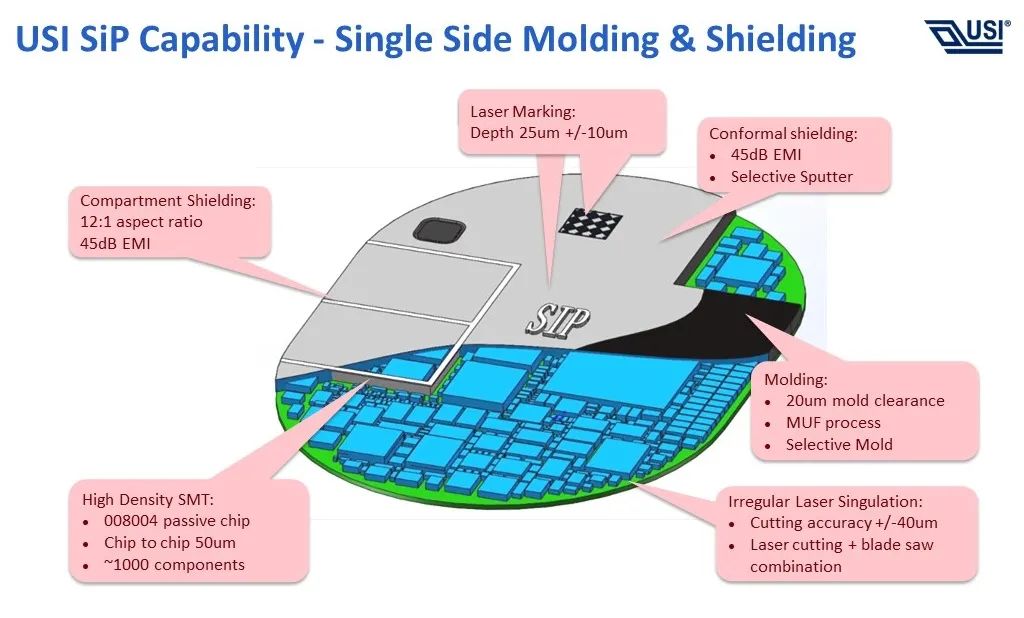
зҺҜж—ӯз”өеӯҗзі»з»ҹзә§е°ҒиЈ…SiPжЁЎеқ—еҫ®е°ҸеҢ–еҲ¶зЁӢжҠҖжңҜиғҪеҠӣдё»иҰҒжңүеҚ•йқўеЎ‘е°Ғ(Single Side Molding, SSM)е’ҢеҸҢйқўеЎ‘е°Ғ(Double Side Molding, DSM)гҖӮе…¶дёӯеҚ•йқўеЎ‘е°Ғдё»иҰҒж ёеҝғжҠҖжңҜжҳҜй«ҳеҜҶеәҰSiPпјҢд»ҘжҷәиғҪжүӢиЎЁдёәдҫӢпјҢеҸҜиҝҗз”Ё008004иў«еҠЁе…ғ件пјҢй—ҙи·қиҫҫ50μmпјҢеңЁ20жҜ«зұіе·ҰеҸізҡ„дё»жқҝйқўз§ҜдёҠеҸҜзҪ®е…Ҙ1000еӨҡйў—е…ғ件пјӣйҮҮз”ЁMoldingеҪўејҸпјҢдёҚйңҖиҰҒUnderfillзӮ№иғ¶пјҢеҠ дёҠLaser Marking зҡ„иғҪеҠӣпјҢжӣҙеҸҜжңҖеӨ§еҢ–иҠӮзңҒз©әй—ҙдёҺжҲҗжң¬гҖӮ
еҸҢйқўеЎ‘е°Ғ
Double Side Molding, DSM
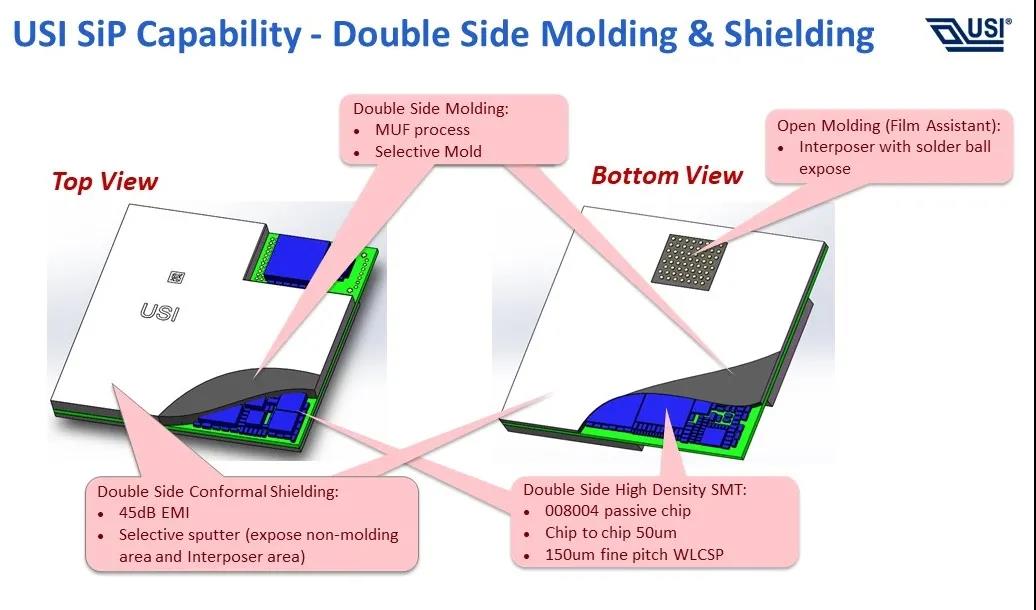
еҸҢйқўеЎ‘е°Ғ(Double Side Molding, DSM)е…ҲиҝӣеҲ¶зЁӢжҠҖжңҜпјҢдёәдәҶжңүж•Ҳең°еҲ©з”Ёз©әй—ҙйӣҶжҲҗжӣҙеӨҡзҡ„е…ғеҷЁд»¶еҝ…йЎ»е…ӢжңҚеҲ¶зЁӢдёҠзҡ„еӨҡз§Қеӣ°йҡҫпјҢе°Өе…¶еңЁеҸҢйқўжЁЎе…·дёҺеұҸи”Ҫзҡ„еҲ¶зЁӢгҖҒCavity SMTжҖ§иғҪзҡ„ж”№е–„пјҢеҠ дёҠй“ҒжЎҶдёҺFlex еҲ¶зЁӢиғҪеҠӣзҡ„ејҖеҸ‘пјҢзӣ®еүҚе·Із»ҸйЎәеҲ©еңЁ2021е№ҙеҜје…ҘйҮҸдә§гҖӮзҺҜж—ӯз”өеӯҗжҢҒз»ӯеңЁе…ҲиҝӣеҲ¶зЁӢжҠҖжңҜдёҠз ”з©¶еҸ‘еұ•пјҢе»әзҪ®SMT并结еҗҲжү“зәҝ(Wire Bond)е’ҢзІҳжҷ¶(Die Bond) ж•ҙеҗҲдә§зәҝпјҢз»Ҳз«Ҝдә§е“Ғе®ўжҲ·еҸҜд»ҘзӣҙжҺҘжҠ•е…Ҙжҷ¶еңҶпјҢзӣҙжҺҘеҲ¶йҖ дә§еҮәжЁЎеқ—зҡ„ж•ҙеҗҲжңҚеҠЎпјҢеҠ еҝ«дә§е“Ғзҡ„дёҠеёӮж—¶зЁӢпјҢд№ҹеҲ©з”ЁжүҮеҮәеһӢе°ҒиЈ…иҝһз»“(Fan Out Interposer)зӯүжҠҖжңҜдҝқжҢҒз”өи·ҜиҒ”йҖҡжҖ§пјҢзЎ®дҝқз”өи·ҜдёҚеҸ—й«ҳеәҰйӣҶжҲҗзҡ„жЁЎеқ—еҪұе“ҚпјҢеҗҢж—¶еўһеҠ дё»жқҝзҡ„з©әй—ҙеҲ©з”ЁзҺҮгҖӮ
ж—ҘжңҲе…үдёҺзҺҜж—ӯз”өеӯҗж·ұиҖ•еҗҲдҪңеӨҡе№ҙпјҢз§ҜзҙҜеңЁзі»з»ҹзә§е°ҒиЈ…SiPд»Һе°ҒжөӢеҲ°зі»з»ҹз«Ҝзҡ„з»„иЈ…ж•ҙдҪ“и§ЈеҶіж–№жЎҲпјҢжңӘжқҘе°ҶжҸҗдҫӣз»Ҳз«Ҝдә§е“Ғе®ўжҲ·жӣҙдјҳеҢ–зҡ„и®ҫи®ЎгҖҒеҲ¶йҖ дёҠзҡ„ж•ҙеҗҲдёҺеј№жҖ§еҢ–зҡ„иҗҘиҝҗпјҢеҸ‘еұ•й«ҳжҖ§иғҪгҖҒеҫ®е°ҸеҢ–жЁЎеқ—пјҢеҠ йҖҹиҝҺжқҘзі»з»ҹзә§е°ҒиЈ…SiPж–°еә”з”ЁжңәдјҡгҖӮ